无铜环双界面智能卡封装框架制作方法,属于电子信息技术领域,主要应用于IC封装框架领域。本发明首先采用一面带铜的环氧树脂布,经冲压、前处理、覆膜、曝光、显影、蚀刻制作出第二接触层(3);再在无铜箔面贴铜箔、烘干、前处理、覆膜、曝光、显影、蚀刻制作出第一接触层(2);然后,对第一接触层(2)和第二接触层(3)进行表面处理。导电线大大减少的双界面智能卡封装框架,减少了镀金的面积,节约了成本。而且贴入芯片时,减少了导线因与铜环接触而发生短路的可能性。

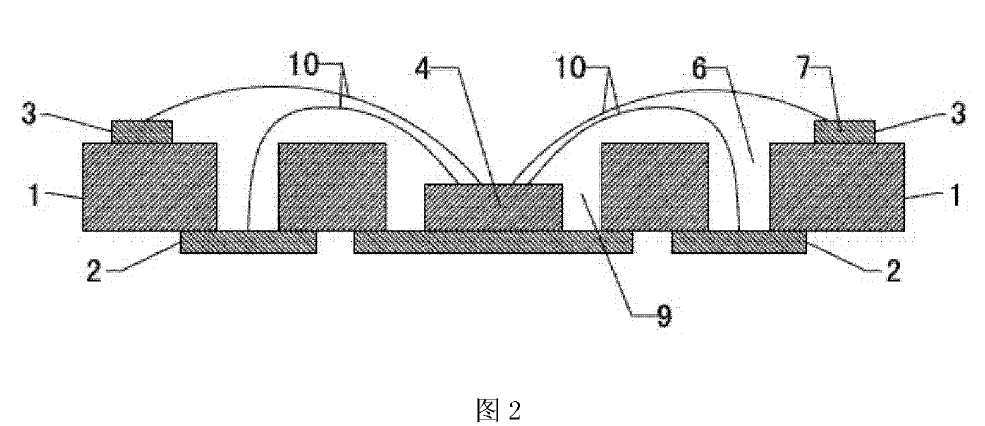
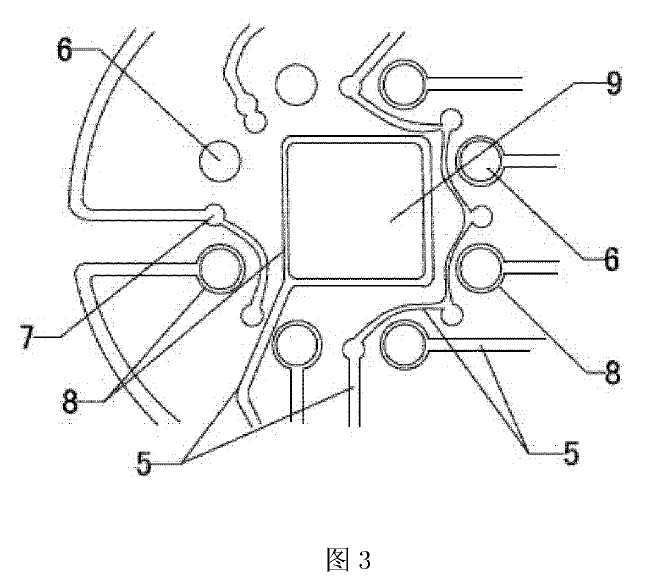
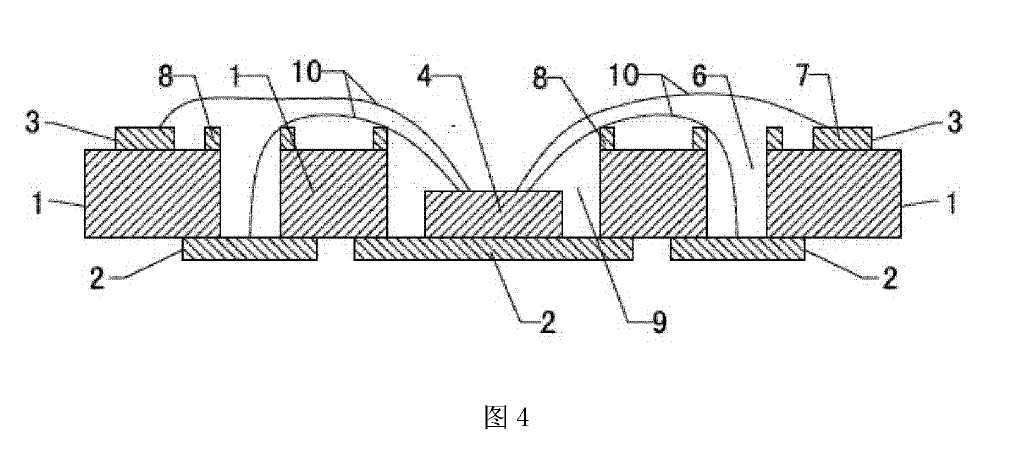
技术领域
[0001] 无铜环双界面智能卡封装框架制作方法,属于电子信息技术领域,主要应用于IC封装框架领域。
背景技术
[0002] 智能卡,也称IC卡(Integrated Circuit Card,集成电路卡)、智慧卡(intelligent
card)、微电路卡(microcircuit card)或微芯片卡等。它是将一个微电子芯片嵌入符合ISO
7816标准的卡基中,做成卡片形式。智能卡是继磁卡之后出现的又一种新型信息工具。一般常见的智能卡采用射频技术与读卡器进行通讯。它成功地解决了无源(卡中无电源)和免接触这一难题,是电子器件领域的一大突破。主要用于公交、轮渡、地铁的自动收费系统,也应用在门禁管理、身份证明和电子钱包。
[0003] 智能卡目前有单界面的产品和双界面的产品。其中单界面的产品是指智能卡单面有功能性铜块设计。双界面的产品是指智能卡双面有功能性铜块设计。一般传统的双界面做法是双面的铜块设计一起形成的。这样的做法必须在焊接孔上覆盖干膜以保护焊接孔,防止蚀刻液通过焊接孔蚀刻到第一接触层的模块。为了固定住焊接孔上的干膜必须设计铜环在焊接孔边缘。这些铜环必须电镀上镍和金。为了要把它电镀,铜环必须要加上电镀线。压焊面铜环没有实际意义,且面积很大,全部镀金,浪费金,增加成本。有铜环时,导电线很多,贴入芯片时,导线很容易与铜环接触,造成短路。有铜环时,铜环导电线众多,对产品设计有约束,要考虑每条电镀线走向,产品设计繁琐,产品不美观。
[0004] 参照附图3?4
:传统方法得到的双界面智能卡封装框架产品,包括基层1、第一接触层2、第二接触层3、芯片4、导电线5、焊接孔6、焊接块7、铜环8、芯片承载面9、导线10,所述的基层I为中间层,第一接触层2和第二接触层3分别包覆基层I的正反面,所述的芯片承载面9和焊接孔6为穿透基层I和第二接触层3的孔洞,芯片承载面9和焊接孔6的边沿上均设有铜环8,铜环8均连有其电镀用的导电线5。芯片承载面9的中心有装在第一接触层2反面的芯片4,第二接触层3的表面分布有焊接块7,所述的导线10穿过芯片承载面9和焊接孔6连接第一接触层2和芯片4。导电线5排列较紧密不美观的同时设计较繁琐,且实际加工难度较大,由于导线10需穿过芯片承载面9和焊接孔6,易与其边沿的铜环8发生短路,成为废品。电镀面积很大,增加了成本,铜环8与大多数导电线5没有实际作用,白白浪费材料。
[0005] 旧工艺流程:冲压一贴铜箔一烘干一前处理一压干膜一曝光一显影一蚀刻/脱膜一表面处理一分切一尺寸检验。
发明内容
[0006] 本发明要解决的技术问题是:克服现有技术的不足,提供一种压焊面无铜环节约成本的无铜环双界面智能卡封装框架制作方法。
[0007] 本发明解决其技术问题所采用的技术方案是:该无铜环双界面智能卡封装框架制作方法,其特征在于:
首先,采用一面带铜的环氧树脂布,经冲压、前处理、覆膜、曝光、显影、蚀刻制作出第二接触层;
再在无铜箔面贴铜箔、烘干、前处理、覆膜、曝光、显影、蚀刻制作出第一接触层;
然后,对第一接触层和第二接触层进行表面处理。。
[0008] 所述无铜环双界面智能卡封装框架制作方法的具体工艺步骤为:
1、冲压:铜面朝上对一面带铜的环氧树脂布冲压出焊接孔;
2、前处理:除去铜表面的氧化物、油脂和杂质,清洁并粗化铜面;
3、覆膜:将感应膜抗蚀剂覆盖在前处理后的铜面上;
4、曝光:覆膜后的铜面使感应膜抗蚀剂接受紫外光照射,使其内的光引发剂分解为自由基,激发单体产生聚合反应形成高分子化合物将图形转移在铜面上;
5、显影:利用碳酸钠溶液的弱碱性将感应膜上未经紫外线辐射的部分溶解,保留经紫外线辐射而发生聚变反应的部分,工艺参数:温度:2(T6(TC,Na2CO3溶液浓度:5?15
g/L,药水喷淋压力:0· Γ0. 2Mpa,水洗压力:0· Γ0. 2Mpa,干燥温度:3(Tl00°C,传送速度l?10m/min
;
6、蚀刻:将铜面接触化学溶液镂空成型,制作出第二接触层;
7、贴铜箔:将一面带铜的环氧树脂布的无铜面再利用热压轮的压力和环氧树脂的粘度将铜箔与环氧树脂布面紧密贴合;工艺条件:热压轮压力:0.
Γ0. 3Mpa,张力:10(Γ2000,热压轮温度:8(T200°C,速度:0. 5?10m/min
;
8、烘干:对新贴铜箔进行加热处理,使铜箔和环氧树脂布进行二次紧密贴合;再对新贴铜箔的一面进行所述前处理、覆膜、曝光、显影、蚀刻的处理,制作出第一接触层;
9、表面处理:对第一接触层和第二接触层的表面进行电镀处理,镀上惰性金属覆盖铜面,保护铜面。
[0009] 优选的,所述的步骤5显影的工艺参数:温度:25?35°C,Na2CO3溶液浓度:8?12 g/L,药水喷淋压力:0. 14?0·
17Mpa,水洗压力:0. 14?0·
17Mpa,干燥温度:6(T70°C,传送速度3?5m/min。
[0010] 优选的,所述的步骤7贴铜箔的工艺参数:热压轮压力:0· 15^0.
25Mpa,张力:900?1200,热压轮温度:13(Tl50°C,速度:5. 0?7·
Om/min。
[0011] 所述步骤2前处理的方法为喷砂研磨法、化学处理法或机械研磨法。
[0012] A
:喷砂研磨法有两种,一种称为喷射研磨法,以高压方式直接将火山岩粉末直接喷向铜面,达到粗化表面的目的。另一种为低压研磨法,先以低压喷砂使流出铜面再以白色尼龙刷研磨,此两种方法均以火山岩粉末为介质研磨铜面达到一定的粗糙度、均匀度并去除杂质及氧化物。
[0013] B:化学处理法利用酸性氯化铜与铜面作用,去除铜表面氧化物、杂质并可蚀刻微量金属铜,使铜面结构发生变化以增加铜面均匀性、粗糙度并增加铜表面活性,以利于下一制程作业。
[0014] C
:机械研磨法指用尼龙刷或织布依靠压力直接接触铜面并在传动带动下与铜面相互摩擦,借以改变铜面结构,一般可按照制程需要将刷磨分为四类:重刷磨、中刷磨、轻刷磨、微刷磨,主要通过刷轮磨粒目数不同来区分。[0015] 所述的步骤3覆膜为贴覆干膜。上干膜所用的干膜种类为溶剂型干膜、水溶性干膜和剥离型干膜。覆膜步也可以是涂覆湿膜。
[0016] 干膜品牌:杜邦干膜,旭化成干膜,日立干膜,长兴干膜,任知干膜,长春干膜,科隆干膜。其中日立干膜是为高密度印制线路板的线路形成而开发的碱性显影型感光性干膜,具有优良的凹凸追从性、密着性和解像度的特性,使用在内层/柔性线路板的蚀刻保护膜上有良好的特性。
[0017] 所述的步骤6蚀刻分为酸性氯化铜蚀刻、碱性氯化铜蚀刻和氯化铁蚀刻。
[0018] A、酸性氯化铜蚀刻,蚀刻机理:
Cu+CuCl2
— Cu2Cl2
Cu2C12+4 CF — 2 (CuCl3)
B、碱性氯化铜蚀刻,蚀刻机理:
CuCl2 + 4NH3 — Cu
(NH3) 4C12 Cu (NH3) 4C12+Cu — 2Cu (NH3) 2C1
C、氯化铁蚀刻,蚀刻机理:
FeCl3+Cu —
FeCl2+CuCl FeCl3+CuCl — FeCl2+CuCl2 CuCl2+Cu —
2CuCl
所述的步骤9表面处理中镀铜层是为了增进电镀层附着能力,及抗蚀能力;镀镍层是为了增进抗蚀性及耐磨性;镀金层是为了改善导电接触阻抗,增进信号传输,增加抗蚀性、耐磨性、抗氧化性,使产品表面更加美观。
[0019] 传统工艺是第一接触层和第二接触层一起做出,而本发明工艺是先做第二接触层,后做第一接触层。对比本发明、传统两种工艺,本发明在贴铜之前,多了前处理一覆膜一曝光一显影一蚀刻这5道工序,其目的就是先将第二接触层没有用的铜蚀刻掉。而在蚀刻过程中无需防止蚀刻液通过焊接孔蚀刻到第一接触层。也无需在焊接孔外加铜环,加导电线。
[0020] 与现有技术相比,本发明的无铜环双界面智能卡封装框架制作方法所具有的有益效果是:本发明方法无需第二接触层的铜环及相应的导电线,减少了镀金的面积,节约了成本,使电镀镍层和金层的面积减少25?40%。而且贴入芯片时,减少了导线因与铜环接触而发生短路的可能性。本发明产品设计生产时,第二接触层铜环及导电线,功能区域更加简洁明朗,产品设计更加方便美观。
附图说明
[0021] 图1是无铜环双界面智能卡封装框架制作方法的产品第二接触层局部结构示意图。
[0022] 图2是无铜环双界面智能卡封装框架制作方法的产品接芯片后剖视结构示意图。
[0023] 图3是传统技术双界面智能卡封装框架产品结构第二接触层局部示意图。
[0024] 图4是传统技术双界面智能卡封装框架产品接芯片后剖视结构示意图。
[0025] 其中:1、基层2、第一接触层3、第二接触层4、芯片5、导电线6、焊接孔
7、焊接块8、铜环9、芯片承载面10、导线。图Γ2是本发明无铜环双界面智能卡封装框架制作方法的最佳实施例,下面结合附图f 4对本发明做进一步说明。
具体实施方式
[0026] 参照附图广2
:本发明无铜环双界面智能卡封装框架制作方法的产品,包括基层1、第一接触层2、第二接触层3、芯片4、导电线5、焊接孔6、焊接块7、芯片承载面9和导线10,所述的基层I为中间层,第一接触层2和第二接触层3分别包覆基层I的正反面,所述的焊接孔6为穿透基层I和第二接触层3的孔洞,芯片承载面9的中心装芯片4,芯片4与留设的焊接孔6的第一接触层2的内面和各焊接块7之间有导线连接;第二接触层3的表面分布有焊接块7和导电线5,焊接块7和导电线5排布疏松清晰,导线10穿过芯片承载面9和焊接孔6连接第一接触层2和芯片4。第二接触层芯片承载面9和焊接孔6的边缘没有铜环,也没有连接铜环的导电线,结构简单,一目了然。
[0027] 下面结合具体实施例对本发明无铜环双界面智能卡封装框架制作方法做进一步说明,其中实施例1为最佳实施例。
[0028] 实施例1
1、冲压:铜面朝上对一面带铜的环氧树脂布冲压出焊接孔;
2、前处理:用双氧水和硫酸与铜面作用,去除铜表面氧化物、杂质并可蚀刻微量金属铜,使铜面结构发生变化,以增加铜面均匀性、粗糙度并增加铜表面活性;
3、覆膜:通过热压方式将日立干膜覆盖在前处理后的铜面上,工艺参数:热压轮温度:110°C,热压轮压力:0.
13Mpa,压干膜速度:4. 5m/min
;
4、曝光:上干膜后的铜面侧使干膜抗蚀剂接受紫外光照射,光引发剂分解为自由基,激发单体产生聚合反应形成高分子化合物将图形转移在铜面上,工艺参数:41格曝光尺格数为22格;
5、显影:利用碳酸钠溶液的弱碱性将干膜上未经紫外线辐射的部分溶解,已经紫外线辐射而发生聚变反应的部分会保留,工艺参数??温度:30°C,Na2CO3溶液浓度:10
g/L,药水喷淋压力:0. 16Mpa,水洗压力:0. 16Mpa,干燥温度:65°C,传送速度4m/min
;
6、蚀刻:用酸性氯化铜溶解腐蚀掉未被干膜保护的铜面;
7、贴铜箔:将一面带铜的环氧布的无铜面再利用热压轮的压力和环氧树脂的粘度将一铜箔与环氧玻璃布面紧密贴合;工艺条件:热压轮压力:0.
2Mpa,张力:1000,热压轮温度:140°C,速度:3m/min
;
8、烘干:对新贴铜箔进行加热处理,使环氧树脂硬化从而使铜箔和环氧玻璃布更好更紧密的贴合在一起;再对新贴铜箔的一面进行所述前处理、上干膜、曝光、显影、蚀刻的处理;
9、表面处理:对两面均进行电镀处理,镀上金层覆盖铜面,保护铜面。
[0029] 产品第二接触层芯片承载面和焊接孔边沿无铜环,剩余导电线排列清晰,批量生产中累计八个月无因短路问题导致的废品。
[0030] 实施例2
1、冲压:铜面朝上对一面带铜的环氧布冲压;
2、前处理:将火山岩粉末以高压喷向铜面,使铜面粗化,除去铜面侧的氧化物、油脂和杂质,清洁并粗化板面;
3、覆膜:通过热压方式将日立干膜抗蚀剂覆盖在前处理后的铜面上,工艺参数:热压轮温度:120°C,热压轮压力:0.1Mpa,压干膜速度:4m/min
;
4、曝光:上干膜后的铜面侧使干膜抗蚀剂接受紫外光照射,光引发剂分解为自由基,激发单体产生聚合反应形成高分子化合物将图形转移在铜面上,工艺参数:41格曝光尺为12格;
5、显影:利用碳酸钠溶液的弱碱性将干膜上未经紫外线辐射的部分溶解,已经紫外线辐射而发生聚变反应的部分会保留,工艺参数??温度:35°C,Na2CO3溶液浓度:12
g/L,药水喷淋压力:0. 17Mpa,水洗压力:0. 17Mpa,干燥温度:70°C,传送速度5m/min
;
6、蚀刻:用酸性氯化铜溶解腐蚀掉未被干膜保护的铜面;。
[0031] 7、贴铜箔:将一面带铜的环氧布的无铜面再利用热压轮的压力和环氧树脂的粘度 将一铜箔与环氧玻璃布面紧密贴合;工艺条件:热压轮压力:0.
25Mpa,张力:1200,热压轮温度:150°C,速度:5. Om/min
;
8、烘干:对新贴铜箔进行加热处理,使环氧树脂硬化从而使铜箔和环氧玻璃布更好更紧密的贴合在一起;再对新贴铜箔的一面进行所述前处理、上干膜、曝光、显影、蚀刻的处理;
9、表面处理:对两面均进行电镀处理,镀上钼层覆盖铜面,保护铜面。
[0032] 产品第二接触层芯片承载面和焊接孔边沿无铜环,剩余导电线排列清晰,批量生产中累计八个月无因短路问题导致的废品。
[0033] 实施例3
1、冲压:铜面朝上对一面带铜的环氧布冲压;
2、前处理:将火山岩粉末以高压喷向铜面,使铜面粗化,除去铜面侧的氧化物、油脂和杂质,清洁并粗化板面;
3、覆膜:通过热压方式将日立干膜抗蚀剂覆盖在前处理后的铜面上,工艺参数:热压轮温度:100°C,热压轮压力:0.
3Mpa,压干膜速度:7m/min
;
4、曝光:上干膜后的铜面侧使干膜抗蚀剂接受紫外光照射,光引发剂分解为自由基,激发单体产生聚合反应形成高分子化合物将图形转移在铜面上,工艺参数:21格曝光尺格数为15格;
5、显影:利用碳酸钠溶液的弱碱性将干膜上未经紫外线辐射的部分溶解,已经紫外线辐射而发生聚变反应的部分会保留,工艺参数??温度:25°C,Na2CO3溶液浓度:8
g/L,药水喷淋压力:0. 14Mpa,水洗压力:0. 14Mpa,干燥温度:60°C,传送速度3m/min
;
6、蚀刻:用碱性氯化铜溶解腐蚀掉未被干膜保护的铜面;
7、贴铜箔:将一面带铜的环氧布的无铜面再利用热压轮的压力和环氧树脂的粘度将一铜箔与环氧玻璃布面紧密贴合;工艺条件:热压轮压力:0.
15Mpa,张力:900,热压轮温度:130°C,速度:7m/min
;
8、烘干:对新贴铜箔进行加热处理,使环氧树脂硬化从而使铜箔和环氧玻璃布更好更紧密的贴合在一起;再对新贴铜箔的一面进行所述前处理、上干膜、曝光、显影、蚀刻的处理;
9、表面处理:对两面均进行电镀处理,镀上金层覆盖铜面,保护铜面。[0034] 产品第二接触层芯片承载面和焊接孔边沿无铜环,剩余导电线排列清晰,批量生产中累计八个月无因短路问题导致的废品。
[0035] 实施例4
1、冲压:铜面朝上对一面带铜的环氧布冲压;
2、前处理:将火山岩粉末以高压喷向铜面,使铜面粗化,除去铜面侧的氧化物、油脂和杂质,清洁并粗化板面;
3、覆膜:通过热压方式将日立干膜抗蚀剂覆盖在前处理后的铜面上,工艺参数:热压轮温度:80°C,热压轮压力:0.1Mpa,压干膜速度:lm/min
;
4、曝光:上干膜后的铜面侧使干膜抗蚀剂接受紫外光照
射,光引发剂分解为自由基,激发单体产生聚合反应形成高分子化合物将图形转移在铜面上,工艺参数:21格曝光尺格数为6格;
5、显影:利用碳酸钠溶液的弱碱性将干膜上未经紫外线辐射的部分溶解,已经紫外线辐射而发生聚变反应的部分会保留,工艺参数:温度:20°C,Na2CO3溶液浓度:15
g/L,药水喷淋压力:0. 2Mpa,水洗压力:O. 2Mpa,干燥温度:30°C,传送速度lm/min
;
6、蚀刻:用酸性氯化铜溶解腐蚀掉未被干膜保护的铜面;
7、贴铜箔:将一面带铜的环氧布的无铜面再利用热压轮的压力和环氧树脂的粘度将一铜箔与环氧玻璃布面紧密贴合;工艺条件:热压轮压力:0.1Mpa,张力:100,热压轮温度:80°C,速度:0.
5m/min
;
8、烘干:对新贴铜箔进行加热处理,使环氧树脂硬化从而使铜箔和环氧玻璃布更好更紧密的贴合在一起;再对新贴铜箔的一面进行所述前处理、上干膜、曝光、显影、蚀刻的处理;
9、表面处理:对两面均进行电镀处理,镀上金层覆盖铜面,保护铜面。
[0036] 产品第二接触层芯片承载面和焊接孔边沿无铜环,剩余导电线排列清晰,批量生产中累计八个月无因短路问题导致的废品。
[0037] 实施例5
1、冲压:铜面朝上对一面带铜的环氧布冲压;
2、前处理:将火山岩粉末以高压喷向铜面,使铜面粗化,除去铜面侧的氧化物、油脂和杂质,清洁并粗化板面;
3、覆膜:通过热压方式将日立干膜抗蚀剂覆盖在前处理后的铜面上,工艺参数:热压轮温度:150°C,热压轮压力:0.
5Mpa,压干膜速度:10m/min
;
4、曝光:上干膜后的铜面侧使干膜抗蚀剂接受紫外光照射,光引发剂分解为自由基,激发单体产生聚合反应形成高分子化合物将图形转移在铜面上,工艺参数:41格曝光尺为30格;
5、显影:利用碳酸钠溶液的弱碱性将干膜上未经紫外线辐射的部分溶解,已经紫外线辐射而发生聚变反应的部分会保留,工艺参数??温度:60°C,Na2CO3溶液浓度:5
g/L,药水喷淋压力:0.1Mpa,水洗压力:0.1Mpa,干燥温度:100°C,传送速度10m/min
;
6、蚀刻:用氯化铁溶解腐蚀掉未被干膜保护的铜面;
[0040] 7、贴铜箔:将一面带铜的环氧布的无铜面再利用热压轮的压力和环氧树脂的粘度将一铜箔与环氧玻璃布面紧密贴合;工艺条件:热压轮压力:0.
3Mpa,张力:2000,热压轮温度:200°C,速度:10m/min
;
8、烘干:对新贴铜箔进行加热处理,使环氧树脂硬化从而使铜箔和环氧玻璃布更好更紧密的贴合在一起;再对新贴铜箔的一面进行所述前处理、上干膜、曝光、显影、蚀刻的处理;
9、表面处理:对两面均进行电镀处理,镀上金层覆盖铜面,保护铜面。
[0038] 产品第二接触层芯片承载面和焊接孔边沿无铜环,剩余导电线排列清晰,批量生产中累计八个月无因短路问题导致的废品。
[0039] 以上所述,仅是本发明的较佳实施例而已,并非是对本发明作其它形式的限制,任何熟悉本专业的技术人员可能利用上述揭示的技术内容加以变更或改型为等同变化的等效实施例。但是凡是未脱离本发明技术方案内容,依据本发明的技术实质对以上实施例所作的任何简单修改、等同变化与改型,仍属于本发明技术方案的保护范围。
无铜环双界面智能卡封装框架制作方法,布布扣,bubuko.com
原文地址:http://www.cnblogs.com/heiyue/p/3761813.html